Services
Die Attach
Product support from ground-breaking research to demonstration and commercialization
Backend Packaging Opportunities for Academic and Industrial Users
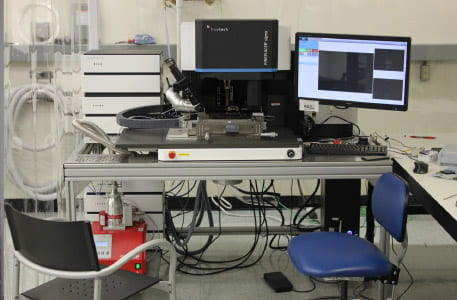 |
 |
 |
Die attach is the process of electrically connecting an active or passive element to a substrate. Our include attachment via solder paste through a reflow oven, solder preforms through a vacuum oven or with brazing materials in a vacuum furnace for extreme environments. Die can also be connected via gold bumps by ultrasonic agitation.
DIE ATTACH SPECIFICATIONS
- Thermocompression & ultrasonic bonding
- AuSn, eutectic, indium & C4 soldering
- Bump, Cu / Cu, & copper pillar bonding
- Precision vacuum bonding & Sintering
- X/Y placement accuracy: ± 0.5 µm
- Theta placement accuracy: ±0.15o
- Bond force: 500 N
- Built in dispense
- Material holders: Film frame, waffle pack & Gel-Pak
VACUUM SOLDER REFLOW SPECIFICATIONS
- Flux and void free soldering
- 80Au20Sn recipe w/ <1% voiding established
- 95Pb5Sn recipe w/ <10% voiding established
- Vacuum down to 50mTorr
- Gas backfill pressure up to 40 psig
- Operating temperature up to 450°C
- Forming gas (4 to 5% H2/N2) equipped
- Formic acid cleaning step established
- 300mm2 graphite heated working plate
SOLDER REFLOW SPECIFICATIONS
- 125mm wide with clearance up to 75mm
- Tunnel length 125cm with 4 independently controlled heating and 2 cooling zones.
- Maximum temperature of 400°C
- N2 flow controls atmosphere to 15ppm of O2
VACUUM BRAZE SPECIFICATIONS
- Flux and void free soldering
- Glass to metal & glass to glass sealing
- Vacuum down to 100mTorr
- Gas backfill pressure > 40 psig
- Operating temperature up to 700°C
- Forming gas (4 to 5% H2/N2) equipped
- 125mm2 graphite heated working plate