Services
Substrate Dicing and Inspection
Product support from ground-breaking research to demonstration and commercialization
Backend Packaging Opportunities for Academic and Industrial Users
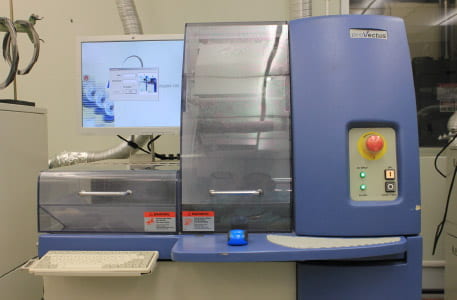 |
 |
 |
Dicing is the process of singulating multiple substrates on one master coupon. Depending on substrate material, thickness, and saw street widths, different dicing blades are available. Our services include wafer inspection if required. Diced coupons can be shipped on the tape frame, otherwise the singulated parts will be sorted into gel or waffle packs.
LTCC SINGULATION SPECIFICATIONS
- Work area: 150mm diameter
- Spindle power: 1,500 Watts
- Spindle speed (fixed) @ 25,000 rev/min
- Blade capacity: 50mm
- Attachment: Film frame or glass carrier
- 50mm blade exposure options:
- 1.27, 1.52, 2.286, 3.048 & 4.57mm
- 50mm blade thickness options:
- 0.1, 0.254 & 0.508mm
LTCC / DBC DICING SPECIFICATIONS
- Work area: 200mm diameter
- Spindle power: 1,400 Watts
- Spindle speed
- 50mm up to 60,000 rev/min
- 76.2mm up to 16,000 rev/min
- Blade capacity: 50mm or 76.2mm
- Attachment: Glass carrier
- 50mm blade exposure options:
- 1.27, 1.52, 2.286, 3.048 & 4.57mm
- 76.2mm blade exposure options:
- 2.286, 3.81 & 7.62mm
SILICON DIE DICING SPECIFICATIONS
- Work area: 200mm diameter
- Spindle power: 1,000 Watts
- Spindle speed: 6,000 to 60,000 rev/min
- Blade capacity: 50mm
- Attachment: Film frame
- 50mm metal blade exposure options:
- 0.8636 & 1.016mm
- 50mm resinoid blade exposure options:
- 1.27, 1.52, 2.286, 3.048 & 4.57mm